目前微波半導體芯片在設計、生產、檢驗和應用等環節需要使用在片(On-wafer)測試設備,但目前各研究機構、單位或公司主要使用國外微波測試產品。而中電科思儀科技股份有限公司生產的的3672系列矢量網絡分析儀可直接應用于On-wafer測試。配合手動探針臺,或半自動探針臺的手動模式,即可滿足部分芯片的On-wafer測試需求,可用于芯片設計測試、芯片高低溫老練等場景。
本文設計了On-wafer測試試驗,搭建基于3672系列矢量網絡分析儀的測試系統,通過對8寸晶圓的某被測件測試,介紹片上校準、片上測試的基本步驟。
1.系統組成
1.1 測試系統
測試系統組成如圖1所示,此系統的主要組成為:
(1)矢量網絡分析儀。型號3672D,頻段10MHz~50GHz;
(2)探針臺。型號:CASCADE 12652B-6;
(3)GSG探針。型號:CASCADE I67-A-GSG-150,間距150μm,2個;
(4)校準件。型號:CASCADE 101-190C,如圖2所示。
1.2被測晶圓
被測晶圓為8寸晶圓,無源元器件,關注的頻率范圍是100MHz-20GHz,晶圓如圖3所示。

圖1 在片測試系統構成

圖2 校準件

圖3 被測晶圓
2 測試流程
2.1 矢量網絡分析儀設置
(1)開啟矢量網絡分析儀預熱充分;
(2)根據測試要求及預測試分析,矢量網絡分析儀的設定值及設置方法如表1所示。
表1 矢量網絡分析儀測試設置及方法

2.2 系統校準
(1)定位及顯示校準片
開啟探針臺,按如圖4所示的步驟依次操作定位校準片位置。

圖4 定位、顯示校準件步驟
(2)顯示及校準探針
探針支架結構如圖5所示,包含四個可調旋鈕控制探針的X、Y、Z和ρ方向,ρ是探針繞Y軸的翻滾角,可調整探針姿態。移動探針并在顯微鏡中觀察直至出現探針的模糊影像;任選一校準件扎下探針,觀察扎痕深淺情況,若扎痕深淺不一致(如圖6所示)需要調整ρ直至深淺一致(如圖7所示)。
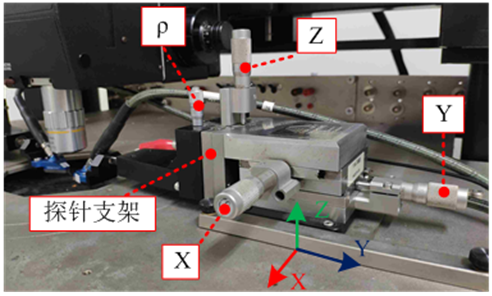
圖5 探針支架結構
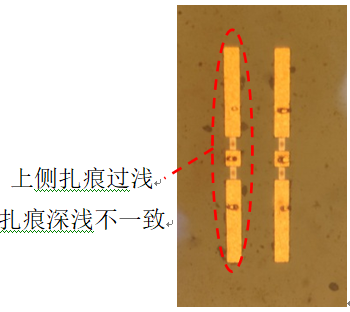
圖6 扎痕深淺不一致需調整

圖7 扎痕深淺一致
(3)校準設置
矢量網絡分析儀中選擇【校準】→[校準…]→[非向導校準],根據校準件和被測件,本次校準采用全雙端口SOLT校準。進入校準界面如圖8所示,點擊[選擇校準件],在彈出窗口中選擇已編輯好的校準件“I67_GSG_150_2”;

圖8 矢量網絡分析儀校準界面
(4)校準